Void-less reflow with plasma
在手机等最新电子设备上搭载的LSI,表面封装的BGA包装以及晶片尺寸封装被大量采用。透过印刷法形成BGA、CSP的 Bump,在晶片上印刷焊锡膏后,用回流炉将粘贴中的焊锡粒子熔化,形成球形 Bump。
但是,在无铅处理和 Bump 微细化的进展,凸起时产生的气泡(void)引起的焊接不良成为问题。
MINAMI在回焊炉工程上的主要区域,在晶片上使用真空空间使焊锡熔化。
达到焊锡的溶解温度(熔点)时,焊锡会从粉末变成液化状态,合金会变化成流动性。
在这个时间点透过“加热+抽真空” 晶片来吸引焊锡内的气体。
根据此工程,比起一般的氮回焊炉,更可以减少减少气泡(void)的产生。
- 等离子
- 透过选配的等离子功能,可以去除焊锡表面的氧化膜,无熔剂的回流变得可以达成。
- 焊接熔化过程
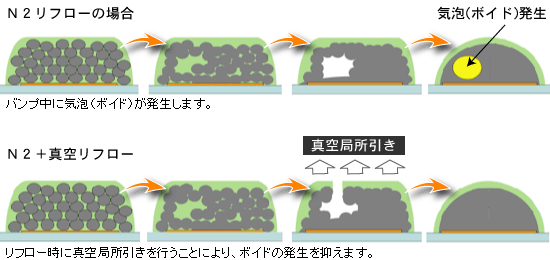
- N2回流和N2+真空回流的比较
-

N2回流可以看到部分产生白色气泡,N2+真空回流侧则没有气泡产生。
-
MINAMI的真空装置附带回流,晶片的移动范围在直径约1.8米的圆周内。
因此更容易提高气密性,透过注入氮气可以将氧气减少到50ppm以下。
并且抑制氧化膜的生成,可以生产低氧气。
除了高气密构造外,回流区域还配备了真空无缝装置。
可以用真空室吸去不能彻底减少的BGA・CSP凸起的气泡(void),形成没有空隙的均匀的Bump。
MINAMI有限公司 总行 邮政编码183-0026 东京都府中市南町5-38-32
Copyright© 2013 MINAMI Co.,Ltd. All rights reserved.
